米格实验室-半导体器件可靠性测试-寿命试验
关注
寿命试验是通过模拟器件工作/贮存环境,以了解产品的平均寿命,寿命特征量,失效规律以及失效模式。
半导体器件出现失效的时间点通常如同下图一样,称为浴盆曲线(Bath-tub Curve)。

曲线可分为三大部分。
失效率下降的区域,也称为早期失效期。试验时间(0-168h),这段区域的主要失效原因一般由于设计、原材料和制造过程中的缺陷造成的。
失效率稳定的区域,也称为随机失效期。试验时间(168-1000h),这一时期是产品的良好使用阶段, 偶然失效主要原因是质量缺陷、材料弱点、环境和使用不当等因素引起的。
失效率上升的区域,也称为损耗失效期。试验时间(>1000h),这一区域的失效率随时间的延长而急速增加, 主要由磨损、疲劳、老化和耗损等原因造成。
通过寿命试验可以研究晶体管抵抗由间歇施加负载引起的结温波动的能力,还可以评估器件早期寿命故障率的等级。适用于功率二极管,SiC肖特基和肖特基二极管,晶闸管,三端双向可控硅和IGBT。
测试温度:≥125℃
测试时间:48-168h
参考标准:JESD22-A108
测试设备:热疲劳试验机

设备能力:
0~80.0V/0~60A
设备特点:
(1)“自动加电”:老化加载实现自适应程控方式,调取器件数据库自动完成试验全过程。
(2)全程监控试验情况,记录试验曲线和数据供试验分析。
(3)每台试验电源由完善的过压、欠压、过流、短路和超温保护功能,确保试验电源的可靠性。
失效案例
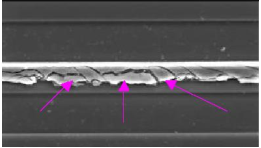
 0
0

相关留言








