二次离子质谱 D-SIMS
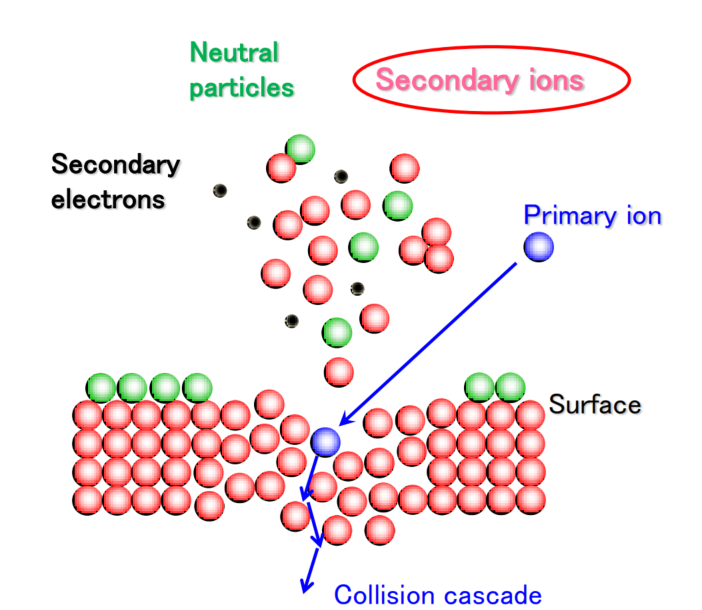
¥面议
周期:3-5个工作日
设备:D-SIMS
SIMS可以探测浓度非常低的掺杂和杂质,也可以提供从几nm到几十µm范围内的元素深度分布。一定能量的离子打到固体表面会引起表面原子分子或原子团的二次发射,即离子溅射。溅射的粒子一般以中性为主,其中有一部分带有正、负电荷,这就是二次离子。利用质量分析器接收分析二次离子就得到二次离子质谱。SIMS具有很高的灵敏度,可达到ppm甚至ppb量级。
如果您的需求与上述内容不符请点击跳转到“需求发布”页面,进行自行订单填写
样品要求
1.样品尺寸8*6mm,样品表面导电且平整,背面平整
2.样品尺寸10*10mm,样品表面导电且平整,背面平整
备注:不同型号设备,尺寸要求稍有差异;不同元素,不同深度,收费有差异;具体联系技术经理咨询
服务描述
最小刻蚀步长:1-2nm
最小分析区域:50*50μm
部分设备能力展示

Cameca IMS 7f
1. 技术指标:
纵向分辨率:2-10nm
离子源:Cs离子及O离子
束斑及能量:30um及以上
质量比分辨率:>4000
杂质检测限:ppm-ppb级别
2. 擅长样品:
Si、GaN、SiGe、SiC、III-V 化合物(GaAs InP GaSb GaN) 以及II-VI (HgCdTe)块体及半导体薄膜材料微量掺杂元素的深度剖析
3. 定量分析:
Si基(P、B、C、H、O等)
GaN基(Mg、Si、C、H、O等)
......
4.应用范围:
掺杂和杂质深度分析
薄膜的组成和杂质的测量(金属、介电质、Si、III-V和II-VI材料)
浅注入和超薄膜的超高分辨率深度分析
块材分析,包括Si中的B C O和 N元素
芯片分析,芯片结构及杂质元素定性定量分析,包括LED芯片、功率器件、氧化镓等半导体芯片
5.离子源选取

案列展示

